기술은 감각이다, 밀론 블로그
Chapter 5.1~5.2 (이온주입) 주입범위, 예제 [반도체공정] feat.jaeger 본문
Chapter 5.1~5.2 (이온주입) 주입범위, 예제 [반도체공정] feat.jaeger
milron 2024. 6. 26. 23:36반도체 8대 공정
1. 실리콘 웨이퍼 제조 공정
2. 산화공정(Oxidation)
3. 포토공정(Photo)
4. 식각공정(Etching)
5. 증착공정(Deposition)
6. 금속배선공정(Metalliztion)
7. EDS 공정(Electrical Die Sorting)
8. 패키지공정(Package)
이온주입이란 무엇인가를 알아보겠습니다.
5. 증착공정(Deposition) 목차
1. Chapter 5.1~5.2 (이온주입) 주입범위, 예제 [반도체공정] feat.jaeger
2. Chapter 5.3~5.4 (이온주입) 주입 깊이, 핵저지, 전자저지 [반도체공정] feat.jaeger
3. Chapter 5-5 (이온주입) Chaneling, Lattice damage, and annealing, 예제 [반도체공정] feat.jaeger
이온 주입을 진행한다면, 이온이 기판으로 주입되는 과정 속에서 어떤 현상이 발생하는지에 대한 지식과 이해가 중요합니다.
Chapter 4 확산 다음으로 알아볼 것은 ion imprantation입니다.
확산에 비해 이온주입은 매우 어렵고 복잡한 대형장비를 필요로 하는 단점이 있는 기술입니다.
고에너지로 인한 격자 결함 발생, 복잡하고 어려워 낮은 생산성, 불가능한 깊은 주입의 단점이 존재합니다.
그러나 이를 상회할 정도의 장점이 있습니다.
원하는 곳의 불순물 주입이 가능합니다.
오차 범위가 적습니다. 또한 표면 환경 조건에 영향을 받는 확산법에 비해, 이온주입은 환경에 영향을 덜 받습니다.
도핑 농도 조절이 용이하며 고용도 제한을 받지 않습니다.
상온에도 동작하여 엄청난 공정 자유도를 보장합니다. 가장 큰 장점입니다.
한 마디로 자유도가 매우 높고 정밀한 주입 공정입니다.
5.1 이온주입(ion implantation)이란?
50 keV ~ 수 MeV의 고 에너지 불순물을 단결정 기판에 강제로 주입하는 기술.
확산, 이온주입의 차이
 |
 |
| (figure 4.3) 확산(diffusion) | (figure 5.2) 이온주입(ion imprantation) |
위 그림들은 위치에 따른 불순물 주입 농도를 의미합니다.
방식에 차이가 있기는 하나 이해를 위해 이러한 이온의 분포도라고 보시면 됩니다.
직관적으로 확인해야 할 부분은 '위치(Distance)에 대한 차이'입니다.
기판에 불순물을 뿌리는 확산과는 달리,
이온 주입은 이온을 레이저 처럼 쏘아 내부로 침투 시키는 것입니다.
이온 주입 그래프가 가우스 분포를 띄고 있다는 점을 유의해 주세요.
5.2 주입 범위(penetration range)
만약 정상작동하는 이온주입 장치가 있고 사용할 준비가 되어있다면,
이제 주입을 시작 해야합니다.
막상 준비는 되었는데 주입을 어떻게 해야할지 모릅니다.
어떤 이온을 사용할 지, 에너지의 정도, 어느정도를 주입할 것 인지 등 예측 범위 전부를 인지하고 있어야 합니다.
고에너지의 불순물 이온은 주입되기 시작하면 여러 단계에 의한 에너지 손실로 정지하게 됩니다.
충돌로 인한 정지죠.
1. 원자 핵에 의해 저지되는 이온저지(nuclear stopping)
핵정지력(nuclear stopping power) 식은 다음과 같습니다.

N : 표적이 되는 기판의 원자 밀도
2. 전자에 의해 저지되는 전자저지 (electronic stopping)
전자정지력(electronic stopping power) 식은 다음과 같습니다.

S_n은 이온의 진행을 얼마나 저지하는지에 대한 저지력입니다.
두 식을 합치면 총 에너지 손실률(dE/dx)이 나올 수 있습니다.

기판의 원자 밀도가 높을 수록 조밀한 공간을 통과해야하는 이온주입 에너지는 더 빨리 줄어들게 될 겁니다.
여기서 이온이 정지되는 순간까지의 거리를 R(range)이고 입사에너지를 E_0라고 가정하면,
이온이 침투한 곳까지의 거리는 다음과 같습니다.

위치 x=0일 때 E=E_0 이므로 부호가 반대로 만들어 적분 순서를 바꿀 수 있습니다.

처음에 보았던 이온 분포도입니다.
x축은 기판의 표면에서 내부까지의 위치입니다.
y축은 이온의 분포도입니다.
이온이 주입되면 실험적으로 위 그림의 그래프와 같이 Gauss 분포를 띄게 됩니다.
따라서 가우스 정규 분표 식을 이용해 얼마나 주입됐는지 알 수 있습니다.
이온 주입의 가우스 정규 분포 식

R_p : (Projectd range)이온의 분포가 확률 적으로 가장 많이 되는 범위.
△R_p : (Straggle)투사 방향의 표준편차, 가우스 분포의 표준편차(x축 편차)로 이해 가능합니다.
△R_t : (transverse range)입사 방향과 수직되는 면의 표준편차(y축 편차).

Q_0는 도즈(dose)라고 1cm^2(단위 면적)당 1초 동안 웨이퍼 표면에 주입되는 불순물의 양을 뜻합니다.
위의 이온 주입의 가우스 정규 분포 식에 의하면
x=R_p 에서 e^0=1이므로 최대 주입농도 N_p가 됩니다.(식 5.6)

유도된 이 식 5.6으로 이제 우리는
1. 어디까지 주입할 것 인가?
2. 얼마나 주입할 것 인가?
를 알 수 있습니다.
굳이 계산할 필요도 없습니다.
이미 선배님들이 아래의 이론으로 다 구해놨으니까요.
LSS(Lindhard, Scharff, Schiott) 이론은 이온주입을 잘 설명해주는 이론입니다.
이 이론으로 여러가지 불순물 주입에너지에 대한 R_p는 다음과 같습니다.
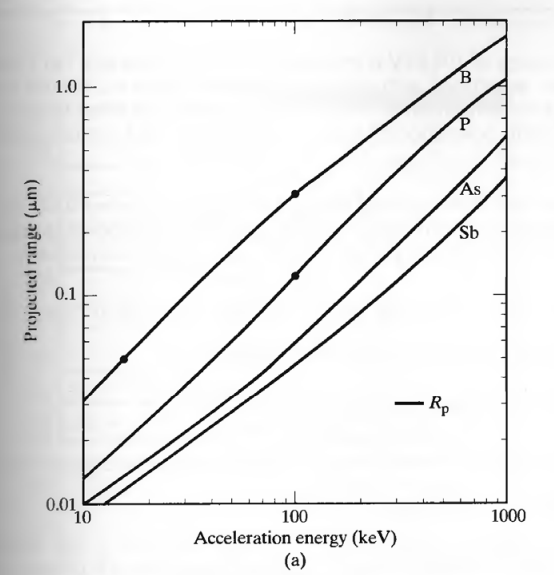
아래 그래프에서 △R_p와 △R_t에 대한 값도 있습니다.

예제 5.1)
Jaeger의 책 예제 하나를 풀고 마무리 하겠습니다.

화학 원소 인(기호 P, Phosphorus)을 에너지 E_0=100 keV로 이온 주입하려고 하네요.
(a) R_p(project range)와 △R_p(straggle)가 얼마인가?
(b) 최대 주입 농도 N_p = 1*10^17 ㎤ 가 되려면 Dose Q를 얼마나 넣어야 하는가?
Solution (a):
그래프를 보면 x축 acceleration energy(keV)에서 100 keV의 P는 각각 다음과 같이 찾을 수 있을 것 같습니다.
R_p = 0.12 ㎛
△R_p = 0.045 ㎛
Solution (b):
먼저 질문 (b)에서 N_p의 값이 1*10^17 ㎤라고 주어집니다.

N_p의 식을 Dose에 대한 식으로 바꿔서 계산합니다.
㎛=0.01㎝ 이고
필요한 Dose Q의 식은 다음과 같습니다.

Solution (c):
이 질문은 다음 포스팅에서 다루겠습니다.
다음 포스팅에서 깊이(junction depth)와 핵저지, 전자저지에 대해 더 설명하겠습니다.
- 저자
- jaeger
- 출판
- 피어슨 에듀케이션
- 출판일
- 2013.08.30
'반도체 > 이온주입(implantation)' 카테고리의 다른 글
| Chapter 5-5 (이온주입) Chaneling, Lattice damage, and annealing, 예제 [반도체공정] feat.jaeger (0) | 2024.06.30 |
|---|---|
| Chapter 5.3~5.4 (이온주입) 주입 깊이, 핵저지, 전자저지 [반도체공정] feat.jaeger (0) | 2024.06.28 |


